HYBRID METROLOGY APPLICATION
UBM/RDL: THICKNESS AND COMPOSITION MONITORING
Analysis of multi-stack structures
and thick mono-layers
Multi-stack structures and thick mono-layers are efficiently analyzed by XRF for layer thickness and composition whereas optical metrology technologies are not capable of simultaneously distinguishing between separate layers, which necessitates measuring each layer before application of the next layer.
Other X-ray techniques such as XRR are not capable of measuring
non-planar structures.
- Multi stack analysis in one shot
- CuNiPd / CuNiAu / CuNiZn
- High-throughput performance
- Multi-element detection is discrete
- Robust fundamental parameter algorithm for thickness extraction
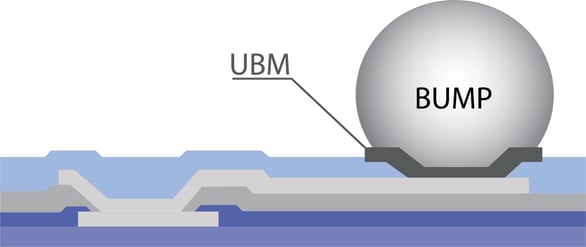
RECOMMENDED RIGAKU SEMICONDUCTOR METROLOGY TOOLS

BUMP INSPECTION SYSTEM
≤ 300 mm Metrology Solutions
ONYX 3000 | Hybrid metrology, XRF and optical x-ray, with a 2D microscope, and 3D Scanner for blanket and patterned wafer thickness, composition, defect identification, and sizing
- Hybrid Configuration
- Micro-spot ED-XRF and 2D- and 3D- optical characterization of device structures
- For FEOL, BEOL, and packaging applications
- For up to 300 mm blanket and patterned wafers



